英特尔展示EMIB+玻璃基板封装,锁定AI、HPC多芯粒整合
创始人
2026-01-23 19:57:09
0次
1月23日消息,据外媒wccftech报道,在近日的NEPCON Japan 展会上,英特尔首度公开展示了结合EMIB 与玻璃基板(Glass Substrate)的先进封装。
报道称,英特尔晶圆代工部门此次展示的是一款“厚核心(Thick Core)玻璃基板”设计,采用EMIB(Embedded Multi-die Interconnect Bridge)进行多芯粒互连,定位明确指向高性能计算(HPC)与AI 服务器市场。该方案被英特尔形容为业界首款玻璃基板+EMIB 组合实例。
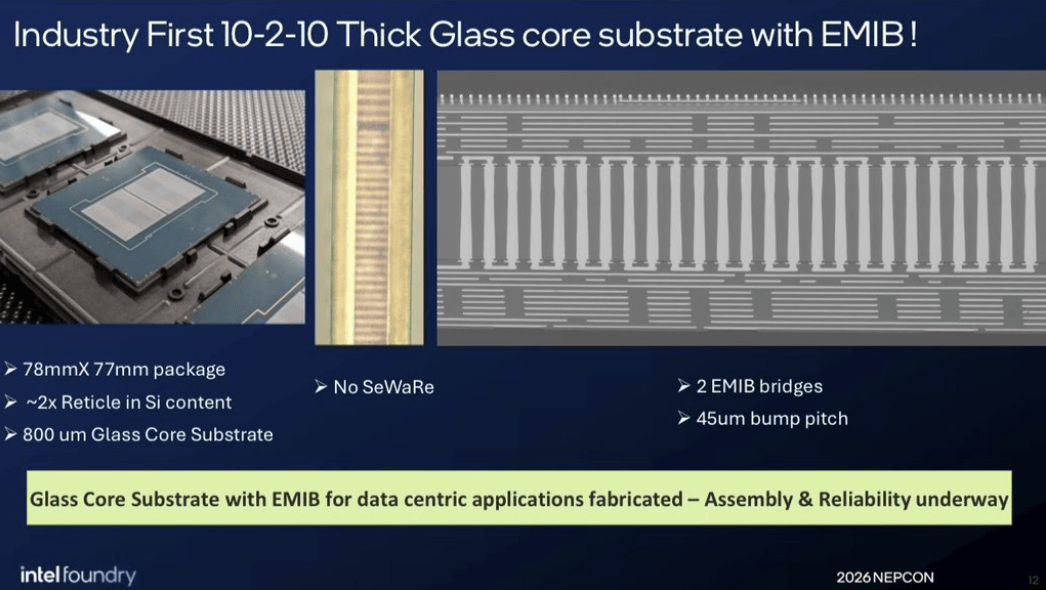
从技术规格来看,该封装尺寸达78mm×77mm,可支持 2 倍reticle 规模,整体结构采10-2-10 堆叠架构,包含10 层RDL、2 层玻璃核心层与10 层下方build-up 层,即便在高密度设计下,仍可维持精细布线能力。英特尔也已在封装中整合两条EMIB 桥接结构,用以连接多颗计算芯粒,对应未来多chiplet GPU 或AI 加速器需求。
英特尔在简报中特别标示该方案为“No SeWaRe”,显示其并非锁定消费性产品,而是为服务器等级、长时间高负载运作的应用所设计。相较传统有机基板,玻璃基板具备更佳的尺寸稳定性、布线精细度与机械应力控制能力,有助于支撑更大规模、多晶粒的封装整合。
在先进封装产能持续吃紧、AI 与HPC 晶片对整合密度要求不断提升的背景下,EMIB 技术近年已受到多家HPC 业者关注。英特尔此次同步展示玻璃基板实作,也被视为其在先进封装竞局中,持续押注高阶AI 与数据中心市场的重要信号。
编辑:芯智讯-林子
相关内容
热门资讯
一场分娩,多次医疗失误,新生儿...
2022年3月5日凌晨,甘肃平凉产妇秦红利在顺产时突发脐带脱垂,紧急剖宫产实施时麻药尚未起效,她在剧...
正式通过竣工验收!拓东体育中心...
4月3日,拓东体育中心体育馆提升改造项目正式通过竣工验收。这座拥有66年历史的地标建筑,在完成结构加...
瓷砖胶施工不规范,后期空鼓又掉...
现在不少师傅虽然用上了瓷砖胶,施工时却仍沿用老习惯,比如把瓷砖胶厚贴施工,或是直接往里面掺水泥,这些...
北京二手房装修
在北京,二手房装修是许多家庭改善居住环境的必经之路。无论是为了孩子上学购置的“老破小”学区房,还是地...
济南通报“小酒馆发生坍塌”
济南市天桥区人民政府网站、极目新闻 4月13日,山东济南市天桥区应急管理局发布情况通报:2026年4...
原创 海...
在全球经济和地缘政治的浪潮中,霍尔木兹海峡无疑是一个重要的“海上命脉”。美国总统特朗普所提到的,他呼...
网友为遭绳锁喉重伤男孩筹款超5...
极目新闻记者 詹钘 近日,河南13岁男孩被绳锁喉一事,引发网友关注。有消息称,事发后,肇事方只给了1...
松阳县咏彩兴邦胶粘石地坪施工队...
松阳县胶粘石地坪地面路面包工包料包清工半包全包施工队 松阳,一座藏在浙南群山间的田园秘境,千年古村...
高端装修公司网络快速接单全流程...
高端装修客群注重品质与专业,网络接单的核心是用专业内容建立信任、以精准渠道触达目标用户、靠标准化流程...
中国核建招标结果:02中国核建...
证券之星消息,根据天眼查APP-财产线索数据整理,中国核工业建设股份有限公司4月9日发布《02中国核...
